Drei Trends prägen derzeit die Entwicklung der Mikroelektronik: Die Chips werden immer dünner, sie werden immer öfter mittels verschiedenster Leit-Klebetechniken gebondet und zu senkrechten Stapeln, sogenannten Stacked-Dies, aufgebaut und verbunden. Allerdings stellen Handhabung und Assemblierung der dünnen Silizium-Chips hohe Ansprüche an die Fertigungstechnik. Hier sind die Entwickler und Hersteller von Advanced Packaging Produktionslinien gefordert, geeignete Geräte für diese Aufgaben zu entwickeln und zu liefern.
Die Stärke der Halbleiter-Chips sinkt immer weiter: für Leistungsbauteile auf etwa 50 µm, für „intelligentes Papier“ noch weit darunter. Während dünne Chips in der Leistungselektronik durch ihren niedrigen thermischen Widerstand für niedrige Betriebstemperaturen und damit höhere Zuverlässigkeit sorgen, ermöglichen sie in der Identifikationstechnik besondere Aufbauten, wie papierdünne und flexible Gehäuse, allgemein als Etiketten oder Label bekannt. Schließlich lassen sich dünne Chips auch zu Stacked-Dies stapeln, was mit der MultiChip-Modultechnik sehr flache Systeme im Gehäuse ergibt. Allerdings haben dünne Silizium-Chips einige spezielle Eigenschaften: Sie sind aufgrund ihrer geringen Substratstärke flexibel, leicht zerbrechlich und häufig auch gewellt. Geeignete Geräte zur Verarbeitung extrem dünner Wafer müssen darauf abgestimmte Handhabung und schonende Bearbeitung bieten.
Aus vielen Gründen dringen Klebetechnologien immer mehr in die industrielle Fertigungspraxis vor. Kleber und Kleber-Tapes belasten Substrat und Chip thermisch wesentlich weniger, was die Vielfalt der verwendbaren Materialien, zum Beispiel in Richtung Niedertemperatur-Substrate, erweitert. Die Prozessvielfalt der leitenden und nicht leitenden Kleber (wie NCA, ACA, ICA etc.), ihre besonderen Eigenschaften und das breite Spektrum der eingesetzten Kleber und Kleber-Tapes stellen hohe Anforderungen an die Genauigkeit, den Funktionsumfang und die Flexibilität des Equipments, seien es Die-Attach- oder Flip-Chip-Bonder oder eine Kombination daraus.
Verschiedene Funktionen in einem Gehäuse
Die Stacked-Die-Technik dringt zunehmend in neue Marktsegmente vor, da sie extrem hoch integrierte Systeme in einem Gehäuse ermöglicht. Diese können auch aus Schichten unterschiedlicher Technologien bestehen, etwa CMOS-Chips für digitale Verarbeitung, MEMS (mikroelektromechanische Systeme) für Sensor- und Aktor-Funktionen und HF-Frontends für drahtlose Sendeempfänger und Flachantennen. Durch Integration in Z-Richtung kommen solche Systeme mit extrem wenig Grundfläche auf dem Substrat aus. Durch die kurzen Verbindungen verbessern sich die dynamischen Leistungsmerkmale, da wenig parasitäre Elemente die Bandbreite schmälern. Für diese Anwendungen ist äußerste Präzision in allen drei Achsen und Flexibilität der Fertigungsgeräte notwendig.
Um heutige und zukünftige Anforderungen der modernen Assemblierungstechnik zu erfüllen, hat Datacon eine flexible Maschinenplattform geschaffen, die sich durch hohe Präzision, automatischen Wafer-Wechsel, kombinierte Flip-Chip- und Die-Attach-Einheit, automatischen Tool-Wechsel, verschiedene Techniken des Kleberauftrags, lokale Wärmebehandlung, kundenspezifische Tools sowie durch geheizte Bondköpfe auszeichnet, die wertvolle Nebenzeiten in der Fertigung einsparen. So sorgen beim Multi-Chip-Die-Bonder 2200 apm+ präzise Linearmotoren mit dynamischer Servoregelung, eine automatische Kompensation der Temperaturdrift und hochauflösende Kamerasysteme für eine Platziertoleranz in der XY-Ebene von ± 10 µm bei 3 Sigma und eine maximale Verkantung (Theta) von ± 0,15° bei 3 Sigma. Dies ist besonders wichtig für die Flip-Chip-Klebetechniken, die nicht selbstzentrierend arbeiten wie herkömmliche Löttechniken. Die Z-Achse ist für Bond-Funktionen und Kleberauftrag individuell steuerbar, um zum Beispiel gewellte Substrate verarbeiten zu können. Für die anspruchsvolle Leichtmontage ist ein Ultra-Light-Tool vorgesehen, dessen niedrige Bondkraft im Bereich 0 bis 6 g mit einer Wiederholtoleranz von ± 50 mg arbeitet.
Vakuumunterstützte Chipaufnahme vom Träger
Das Wafer-Transportsystem des Flip-Chip-Bonders für extrem dünnes Silizium verarbeitet bis zu 25 unterschiedliche Wafer, für die fünf Ausstechwerkzeuge in einem Karussell angeordnet sind. Bemerkenswert ist der materialschonende, synchrone Bewegungsablauf von Pick-up- und Ausstech-Tool, die Aufnahme des Chip vom Trägermaterial läuft vakuumunterstützt ab. So lassen sich für die Direktmontage Chips ab 170 µm Kantenlänge und für die Flip-Chip-Montage 500 µm Chips handeln. Der automatische Tool-Changer fasst bis zu sechs unterschiedliche Werkzeuge, zu denen ein bis auf 350°C aufheizbarer Bondkopf gehört, der für temperaturgeführte Klebeprozesse in der Flip-Chip-Montage Vorteile bringt.
Zwei Beispiele zeigen die große Fertigungsbandbreite des Multi-Chip-Die-Bonders 2200 apm+: Im Arbeitsbereich von 304 x 203 mm² darf das Substrat bis zu 330 x 203 x 36 mm³ groß sein, als maximale Chipgröße sind 50 mm zugelassen. Mit diesem Equipment wurden intelligente Etiketten (Smart-Labels) aus extrem dünnen Mifare-Transponder-Chips (50 µm dick) mit den Abmessungen 1,11 x 1,08 mm² auf flexibles PI-Substrat mit hoher Ausbeute montiert. Ebenso erfolgte eine Direktmontage von 100 mm2 messenden und 90 µm starken Leistungsmodulen auf kupfer-gebondete Substrate unter Serienproduktionsbedingungen.
EPP 475
Unsere Webinar-Empfehlung
Conformal Coating ist ein wichtiges Verfahren, um elektronische Baugruppen vor dem vorzeitigen Ausfall zu schützen. Damit bekommt der Beschichtungsprozess eine immer höhere Bedeutung. Dabei ist die Auftragsstärke ein wichtiges Qualitätskriterium. Nur eine zeitnahe schnelle Messung…
Teilen:


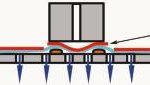


.png)







