Bleifreie Lötverbindungen in Grid-Arrays sind anfälliger für Ausfälle, die sich aus den Unterschieden der thermischen Ausdehnungskoeffizienten zwischen Leiterplatte und Bauteil ergeben. Hauptursachen hierfür sind die geringere Duktilität bleifreier Legierungen und eine stärkere Tendenz der Baugruppe, sich als Folge der höheren maximalen Reflowtemperatur für bleifreie Lote, zu verformen. Verschärft wird diese Situation noch durch die Verkleinerung der Rasterabstände, und die generelle Umstellung auf dünnere Substrate.
Frank Ongkiehong, Henkel Technologies, Garching
Aus diesen Gründen können in Baugruppen mit CSPs, Micro-BGAs oder sogar BGAs, bei denen früher keine Maßnahmen zur Lösung der Problematik aufgrund unterschiedlicher Ausdehnungskoeffizienten notwendig waren, jetzt Unterfüllungen erforderlich werden.
Gegen jede Erwartung …
Als es zu ersten Diskussionen über die obligatorische Verwendung von bleifreien Loten für elektronische Baugruppen kam, wurde in den Stellungnahmen mehrheitlich die Auffassung vertreten, dass eine solche Umstellung auch zu zuverlässigeren Lötverbindungen führen werde. Die Lotlegierungen würden höhere Schmelzpunkte haben, und im Vergleich mit den herkömmlichen SnPb-Loten festere Verbindungen bilden – insbesondere die Kriechfestigkeit sollte größer sein. Legierungen auf SnAg-Basis, die durchgehend als wahrscheinlichster Ersatz für die bewährten eutektischen SnPb-Legierungen favorisiert wurden, besitzen überdies bessere isotherme Werkstoffeigenschaften und bessere Low Cycle Fatigue Eigenschaften, die das Versagen einer Verbindung durch differenzielle thermische Ausdehnung beim Temperatur- oder Stromwechsel beschreibt. Dadurch sollte ihre Lebensdauer inhärent länger sein. Die Werkstoffeigenschaften bleifreier SnAgCu-Legierungen (SAC) lassen vermuten, dass sie geeigneter sein sollten als bleihaltige; reale Baugruppen zeigen aber, dass dies nicht unbedingt der Fall ist. Bei niedrigen Temperatur- und Belastungsraten ist SAC tatsächlich überlegen, aber bei höheren Belastungen ist SnPb besser. Bemerkenswerterweise funktioniert SnPb immer besser, je näher wir an seinen Schmelzpunkt kommen!
In der Praxis ist eine geringfügig kriechende Lötverbindung erwünscht, weil diese Spannungsspitzen abbauen kann, welche durch unterschiedliche thermische Ausdehnungskoeffizienten zwischen Bauteil und Substrat verursacht werden. Ohne diese Nachgiebigkeit neigen die Verbindungen schneller zur Rissbildung. Das Anschlussprinzip der Bauteile beeinflusst die Empfindlichkeit gegen Ausfälle aufgrund Rissbildungen. SOIC- und QFP-Bauteile beispielsweise sind weniger anfällig, weil sich die Bauteilanschlüsse verformen können. Dagegen wurden bei chipförmigen Bauteilen nach nur 2000 Wärmeschockzyklen (25°C bis + 125°C) Brüche in der Verbindung auf einer Bauteilseite beobachtet, die ihren Ursprung unter dem Bauteil hatten, und sich durch die Verbindung hindurch fortsetzten.
Insbesondere lässt die Leistungsfähigkeit bleifreier Verbindungen in Bauteilen nach, die starken mechanischen Spannungen ausgesetzt sind, wie bei CSPs, die eine große Oberfläche im Verhältnis zur Stand-off Höhe haben, und bei denen im normalen Betrieb starke Temperaturschwankungen auftreten. Die geringere Duktilität der bleifreien Lötverbindung kann auch zu einer geringeren Schockbeständigkeit der Lötverbindungen führen. Hiervon können auch größere Komponenten wie BGAs betroffen sein, da die einwirkenden Beschleunigungskräfte proportional mit der Bauteilemasse ansteigen.
Neben der geringeren Duktilität und das geänderte Verhalten unter Wechselbelastung, hat auch das Chip-Design Auswirkungen auf die Zuverlässigkeit der Verbindungen. So führt beispielsweise die höhere Leistungsfähigkeit und Integration zur Erhöhung der Anzahl IOs, zusammen mit dem Trend zur Miniaturisierung der Bauteilmaße, zu immer kleineren Rasterabstände. Dadurch reduziert sich der Durchmesser einer typischen Lotkugel von 0,8 mm auf 0,3 mm, und nicht nur die Fläche der Lötverbindung wird kleiner, sondern auch die Stand-off-Höhe. In solchen Fällen sind die Auswirkungen der unterschiedlichen Ausdehnungskoeffizienten wie beschrieben besonders kritisch zu betrachten.
Ein zusätzlicher Aspekt ist, dass die bei bleifreien Loten erforderlichen höheren Reflow-Spitzentemperaturen die Verformungsneigung der Leiterplatten erhöhen, und damit das Risiko von bleibenden Spannungen innerhalb der Verbindungen. Dies gilt insbesondere für ultradünne Leiterplatten, die auf die Einsparung von Gewicht, Raum und Kosten ausgelegt sind.
Underfiller und bleifreie CSP-Anwendungen
CSPs waren ursprünglich als Bauelement konzipiert, bei denen ein Underfill nicht erforderlich ist. Angesichts erhöhter Spannungen in der Baugruppe, wie sie beim Übergang zu bleifreien Lötverbindungen zu erwarten sind, sollte bei der Planung der Baugruppenfertigung auch der Einsatz von Underfiller betrachtet werden, um die Zuverlässigkeit der Baugruppe zu maximieren. Die Funktion des Underfills, nämlich die Zuverlässigkeit von Grid-Array-Verbindungen zu erhöhen, beruht darauf, dass sie die Spannungen über die Substratfläche verteilt, und ihre Konzentration auf die Lotkugeln verhindert. Bild 1 zeigt an einem Beispiel, wie Underfiller in einer CSP-Anwendung eingesetzt werden können. Der Underfill verbessert die Schockbeständigkeit, und reduziert Spannungen aufgrund unterschiedlicher thermischer Ausdehnungskoeffizienten.
Bei der Bewertung von bleifreien CSP-Bestückungsprozessen sollte der Einsatz eines Underfills in Erwägung gezogen werden.
Obwohl heute bei nur wenigen (doppelseitigen) Reflow-Anwendungen CSPs vor dem Reflowlöten unterfüllt werden, stellt sich die Frage, ob Underfiller die erhöhte Temperaturbelastung ohne Verlust der kritischen Materialeigenschaften überstehen. Moderne Underfiller wie die Loctite/Hysol COB Underfiller basieren auf Formulierungen, die auch in Package-Level-Underfiller für die Bleifrei-Komponentenfertigung eingesetzt werden. Diese bleifrei-kompatiblen Komponenten müssen mehrere 260°C Reflowzyklen überstehen.
Somit sind diese Underfiller bei der bleifreien CSP-Bestückung zu empfehlen.
No-Flow-Underfill für die bleifreie CSP-Bestückung
No-Flow-Underfiller müssen speziell auf den Bleifrei-Prozess abgestimmt sein, da sie vor dem Reflowlöten appliziert werden, und die Fließ- bzw. Aushärte-Eigenschaften genau auf das Bleifrei-Reflowprofil abgestimmt sein müssen. Ihr Aushärtungsverhalten ist speziell darauf ausgelegt worden, dass sich das Bauteil beim Aufschmelzen des Lots ausrichten kann. Diese Selbstzentrierung der Komponenten gleicht mögliche Ungenauigkeiten bei der Bestückung aus. Wie Bild 2 zeigt, bleiben sie flüssig, bis das Aufschmelzen des Lots vollständig erreicht wird. Würden die Underfiller schon vorher aushärten, wäre eine Selbstzentrierung unmöglich: dies hätte eine höhere Fehlerrate aufgrund Bestückungs-Ungenauigkeiten zur Folge. Sollen No-Flow-Underfiller bei der bleifreien Bauteilbestückung eingesetzt werden, muss deshalb ihr Aushärtungsverhalten verändert werden. Das erfordert die Verwendung einer speziellen „bleifreien“ Rezeptur, da die Formulierungen für bleihaltige Anwendungen im Bleifrei-Prozess verfrüht aushärten. Als Beispiel eines No-Flow-Underfills lässt sich Hysol FF2300 anführen. Dieses Produkt ist für die bleifreie Bestückung von Flip-Chips und CSPs geeignet.
Schlussfolgerung
Tests sind unabdingbar. Bei der Umstellung auf bleifrei muss jeder Prozess neu evaluiert werden. Bestehende Prozesse können nicht einfach übernommen werden.
Um zu klären, welche CSPs auf die geringere Zuverlässigkeit von bleifreien Verbindungen besonders empfindlich reagieren, und somit zu verstehen, wann der Einsatz eines Underfills sinnvoll ist, sind individuelle bzw. baugruppenspezifische Untersuchungen dringend erforderlich. Das Engineering Team der Henkel Elektronik Gruppe unterstützt Anwender bei der bleifrei Umstellung und Qualifikation der Prozesse.
EPP 468
Unsere Webinar-Empfehlung
Auch dieses Jahr präsentiert Koh Young wieder aktuelle Trends und „State of the Art“ Technologie aus der optischen Inspektion und 3D-Messung auf der Productronica in München. Aber wir alle kennen das Problem voller Terminkalender, Reisebeschränkungen oder fehlender Zeit, um in…
Teilen:




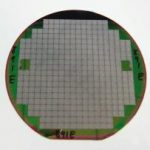
.png)







