Der von der EU-Kommission gesetzte Stichtag 1. Juli 2006 für die ausschließliche Verwendung von bleifreiem Lot vorzugsweise in der Fertigung von Konsumelektronik rückt immer näher. So ist es auch wichtig, die Zuverlässigkeit von bleifreien Lötverbindungen im IC-Packaging intensiv zu untersuchen. Die Charakterisierung von neuen Bleifrei-Lotlegierungen erfolgt sowohl durch Experimente als auch durch weiterentwickelte Simulationsverfahren. In diesem Beitrag gehen die Verfasser auf die einschlägigen Fehlermechanismen ein und geben Hinweise, wie die Zuverlässigkeit der Lötstellen erhöht werden kann.
M. Gonzales, P. Ratchev, R. Labie, P. Limaye und B. Vandevelde, IMEC, Leuven (Belgien)
Im Bereich der Europäischen Union ist es ab Juli 2006 verboten, Konsumelektronik in den Verkehr zu bringen, die Blei sowie diverse andere gefährliche Stoffe wie Quecksilber, hexavalentes Chrom usw. enthält. Das hat natürlich auch weit reichende Folgen für die Hersteller von Mikroelektronik, die seit über 50 Jahren Zinn-Blei-Lote (SnPb) in der Baugruppenfertigung und im Packaging von Bauelementen verwenden. Diese bewährten SnPb-Lote werden nun durch bleifreie Alternativen ersetzt. Doch sind die Anwender der Lote darauf noch nicht ganz eingestellt. Trotz der vielen Studien an bleifreien Lotlegierungen wie SnAg, SnCu, SnAgCu (SAC) gibt es bisher immer noch keinen weltweit gültigen Konsensus über das Material, das verwendet werden sollte. Hauptgrund dafür ist, dass das Verhalten dieser „neuen“ Legierungen, insbesondere ihre Zuverlässigkeit, immer noch nicht in allen Details erschöpfend untersucht ist.
Weil sich das weiche Metall Blei nicht mehr in den Lotlegierungen befindet, verformen sich bei Belastungen die Bleifrei-Lötstellen weniger leicht – und damit steigt die hier einwirkende Stresslast. Dies wiederum erhöht die Wahrscheinlichkeit, dass sich in den Lötstellen Mikrorisse bilden, womit als Hauptursache für Defekte in Lötstellen die Materialermüdung des Lots gelten kann. Zusätzlich zu diesem „thermo-mechanischen“ Effekt der Ermüdung sollten auch die Auswirkungen der Elektromigration auf die Stabilität und Zuverlässigkeit der Lötstellen im Prozess untersucht werden. Es ist absehbar, dass mit der weiteren Miniaturisierung der Mikroelektronik die Auswirkung der Elektromigration nicht mehr negiert werden kann.
In der Untersuchung der Zuverlässigkeit von Lötstellen in bleifreien IC-Packages hat IMEC erhebliche Fortschritte zu verzeichnen. Dazu wurden Simulationstechniken entwickelt, die zusammen mit den Daten aus Experimenten verwendet werden, um wichtige Erkenntnisse über die beobachteten Fehlermechanismen zu gewinnen.
Analyse von bleifreien Flip-Chip-Packages
Im Bereich der bleifreien Löttechnik findet und fand eine große Zahl von Zuverlässigkeitsstudien statt. Dabei wird oft die thermo-mechanische Analyse eingesetzt, denn sie ermöglicht die Zuverlässigkeit von Lötstellen sehr genau zu prognostizieren – noch bevor umfangreiche Testreihen gestartet werden. Jedoch sind in vielen Fällen die Ergebnisse nicht universell einsetzbar oder sogar widersprüchlich. In der Tat sind die Resultate von vielen Faktoren abhängig, beispielsweise vom Packa- ge-Design, den Bedingungen im Temperaturzyklus oder auch von Variationen in der Zusammensetzung der Legierung.
Das Hauptziel unserer Untersuchung ist die Prognose des thermo-mechanischen Verhaltens von Flip-Chip-Packages, in denen SAC-Legierungen (Zinn-Silber-Kupfer) verwendet werden. Solche Flip-Chip-Bauelemente werden vorzugsweise wegen ihrer kleineren Bauformen und der höheren Performance eingesetzt. Wir haben die Ergebnisse unserer Arbeit mit jenen verglichen, die für Packages gelten, in denen eutektisches Blei-Zinn-Lot verwendet wird. Wir haben eine thermo-mechanische FEM-Technik (Finite-Elemente-Modellierung) als CAD-Tool eingesetzt, um das Verhalten von Lötstellen abhängig von Zeit und Temperatur zu analysieren.
Zwei unterschiedliche Flip-Chip-Packages (200 und 300 µm Pitch) und jedes für drei verschiedene Chipgrößen wurden dafür entwickelt. Ein vereinfachtes Modell dieser Flip-Chips fand Anwendung. Lediglich die Lotverbindungen wurden mit einem nichtlinearen Verhalten modelliert. Thermisch verursachte Materialermüdung, der wichtigste Fehlereffekt bei Lötstellen, wurde als der einzige Defektmechanismus berücksichtigt. Für jedes Flip-Chip-Assembly wurde die gesamte Kriechdehnung im Lot berechnet. Die Zahl der Temperaturzyklen bis zum Ausfall wurde der insgesamt ermittelten Kriechdehnung gegenübergestellt, wobei wir auf eine empirisch ermittelte Relation aus der Literatur zurückgriffen.
Das Ergebnis dieser Studie überrascht: Die mit bleifreiem Lot hergestellten Flip-Chips weisen gegenüber jenen mit bleihaltigem Lot eine um 27 bis 51 % höhere Lebensdauererwartung auf. Die höhere Lebensdauer ist besonders deutlich bei den Gehäusen mit 200-µm-Pitch. Eine Konsequenz daraus: Man kann SAC-Legierungen in Flip-Chip-Packages auch einsetzen, um deren Beständigkeit gegenüber Effekten der Materialermüdung zu verbessern.
In einem weiteren Teil dieser Untersuchung wurden die Effekte von Fehlstellen (Lufteinschlüsse) auf die thermische Materialermüdung studiert. Luftbläschen in Lötstellen können zu Zuverlässigkeitsproblemen führen, denn sie konzentrieren den Stressverlauf und können damit Mikrocracks hervorrufen und deren Ausbreitung unterstützen. In der zweidimensionalen FEM-Analyse wurde deutlich, dass die gesamte nichtelastische Kriechdehnung einer Lötstelle mit nur einer Fehlstelle nicht größer ausfiel als ohne Lufteinschluss. Sind jedoch mehrere Fehlstellen in einer Lötstelle zu finden, dann können verstärkt frühzeitige Materialermüdungsdefekte auftreten.
Von Versprödungsbruch zu Dehnungsriss
Die Modellierung der Lebensdauererwartungen der Lötstellen muss von Experimenten begleitet werden, beispielsweise von Temperaturzyklen oder Studien über die Versprödungstemperatur. Es ist natürlich hinreichend bekannt, dass einige Metalle bei niedrigen Temperaturen ihre Verformungsfähigkeit verlieren und stattdessen zu Versprödungsbrüchen neigen. Damit einher geht eine Reduzierung der Widerstandsfähigkeit gegenüber Materialbrüchen. Deshalb ist es wichtig, die Übergangstemperatur von der Verformbarkeit zur Versprödung exakt zu erfassen, erlaubt dies doch den „sicheren“ Anwendungsbereich von bleifreien Legierungen zu definieren.
In der Folge haben wir die Verformungsfähigkeit von mehreren üblichen Bleifrei-Loten untersucht. So wurde die Widerstandsfähigkeit gegen Versprödungsbruch bei den bleifreien Formulierungen Rein-Zinn (99,99Sn), Zinn-Kupfer (Sn0,7Cu) und Sn0,7Cu(Ni), Zinn-Silber (Sn5Ag) und Zinn-Silber-Kupfer (Sn4Ag0,5Cu und Sn3Ag0,5Cu) sowie dem herkömmlichen Zinn-Blei-Lot (Sn37Pb) analysiert. Wobei wir dies als Funktion der Temperatur mit einem Pendelhammertest durchführten, auch bekannt als Charpy-Test.
Die Experimente zeigen klar, dass alle hier untersuchten bleifreien Lote ihr Defektverhalten von Brüchigkeit zu Verformbarkeit änderten. Die Bruchfestigkeit steigt mit abnehmender Temperatur, sie erreicht ihr Maximum kurz vor der Übergangstemperatur. Beobachtet wurden hierbei scharfe Übergänge von Verformbarkeit zu Brüchigkeit. Blei-Zinn-Lote hingegen zeigten keine solchen scharfen Übergänge: Wurde die Temperatur abgesenkt, konnte nur eine leichte Einbuße an Verformbarkeit festgestellt werden.
Die Übergangstemperaturen sind relativ niedrig. Für hochreines Zinn sowie Legierungen des Typs Sn0,5Cu und Sn0,5Cu(Ni) liegt die Übergangstemperatur bei etwa –125 °C. Silberhaltige Lote weisen einen Übergang bei höheren Temperaturen im Bereich von –78 bis –45 °C auf. Die höchste Übergangstemperatur wurde bei Sn0,5Ag festgestellt, das Material ist nur über –30 °C verformbar. Ein höherer Silberanteil scheint die Übergangstemperatur zu höheren Werten hin zu verschieben. Zurückführen lässt sich das wahrscheinlich auf den höheren Volumenanteil von SnAg3-Partikeln im Lot.
Diese Ergebnisse sind sehr wichtig für die Auswahl der am besten geeigneten bleifreien Lotlegierung, insbesondere für raue Umgebungsbedingungen wie in Fahr- oder Flugzeugen. Werden einige dieser bleifreien Lote in ihrem brüchigen Temperaturbereich eingesetzt, kann ein deutlicher Wechsel der Fehlerart, konkret ein katastrophaler Brüchigkeitsriss, erwartet werden. Deshalb kann man davon ausgehen, dass ein sicherer Temperaturbereich für die Anwendung etwa 10 K vor der Übergangstemperatur beginnt (Bild 1).
Elektromigrationsverhalten von Bleifrei-Lötstellen
In den meisten Zuverlässigkeitsstudien liegt das Hauptaugenmerk auf dem thermo-mechanischen Verhalten der Lötstellen. Jedoch konnte beobachtet werden, dass die Elektromigration (Materialtransport, verursacht durch elektrischen Strom) eine sehr große Auswirkung auf die Bildung intermetallischer Schichten zwischen der Padoberfläche (oder der Metallisierung unter dem Bump, UBM) und dem Lot hat. Deswegen hat die Elektromigration erhebliche Auswirkungen auf die Stabilität und Zuverlässigkeit der Lötstellen. Insbesondere problematisch ist dies bei Flip-Chip-Verbindungen in weiter miniaturisierten Schaltungen, wo die Durchmesser der Lotballs und der Kontaktpads sehr gering sind.
Für Untersuchungen der Elektromigration von bleifreien Flip-Chip-Bumps hat IMEC eine spezielle Prüfstruktur entwickelt. Diese neuartige Teststruktur erlaubt nicht nur die Widerstandsänderungen des gesamten Bump-Stapels in 4-Draht-Messungen zu erfassen, sondern auch Widerstandsänderungen an jeder Seite des Bumps (Katoden- und Anodeneffekt) separat festzustellen. Solche Widerstandsänderungen werden durch Elektromigrations-Effekte verursacht. Man nimmt an, dass sich diese Metall-Migration in der Bildung von Fehlstellen an der Katode (wo die Elektronen in die Lötstelle fließen) sowie an den anodenseitigen Metallansammlungen auswirkt. Das erklärt auch das typische asymmetrische Verhalten. Die Teststruktur wurde für Flip-Chip-Verbindungen des Typs CuNiAu – Sn – CuNiAu verwendet.
Eine erheblich raschere Widerstandserhöhung zeigte sich an der Katodenseite des Bumps. Der Widerstand an der Anodenseite bleibt konstant, solange kein Fehler an der Katode auftritt. Die Unterschiede im elektrischen Verhalten zwischen Anoden- und Katoden-Interface lassen sich mikro-strukturellen Änderungen zuschreiben: Ein rascheres Aufbrauchen des UBM-Materials sowie Fehlstellen ereignen sich an der (positiven) Katodenseite. Die Fehlstellen zwischen der intermetallischen Schicht und dem Lotmaterial an der Katodenseite sind die Ursache für höhere Defektraten (Bild 2).
Kobalt in der UBM- Metallurgie bei Fine-Pitch
In Fine-Pitch-Applikationen (Kontaktraster unter 0,1 mm) ist Flip-Chip-Bumping nur mit elektroplattierten Kontakthöckern möglich. Doch aufgrund der Eigenschaften des Elektroplattierungsprozesses ist es sehr schwierig, die üblichen bleifreien Legierungen wie SnAg oder SnAgCu (SAC) zu verwenden. Für solche Applikationen ist Rein-Zinn eine gute Alternative. Zinn lässt sich einfach innerhalb eines Elektroplatingprozesses einsetzen und die Zinn-plattierten Bumps haben sich als sehr zuverlässige Flip-Chip-Anschlüsse erwiesen. Jedoch ist Zinn sehr reaktionsfreudig, deshalb ist die Auswahl des UBM-Materials sehr kritisch. Frühere Untersuchungen ergaben hier höhere Lebensdauerzyklen (um etwa 40 %) bei Verwendung von Kobalt-UBM anstatt von Kupfer-UBM.
Die Finite-Elemente-Modellierung (FEM) ist die am besten geeignete Methode, um diesen Unterschied zu erklären und die Lebensdauer (Materialermüdung) der Lötstelle abzuschätzen. Jedoch betrachtet man in neueren Untersuchungsverfahren die Lötstelle als homogenes Material und blendet den Einfluss von intermetallischen Schichten aus. Doch die kleineren Lötstellen sowie das hohe Reaktionsvermögen von Zinn führen dazu, dass ein höherer prozentualer intermetallischer Anteil am gesamten Volumen des Bumps entsteht. Die derzeitigen Untersuchungsverfahren können nicht die Einflüsse von Materialermüdungen dieser intermetallischen Schichten in der Lötstelle berücksichtigen.
Deshalb betrachtet man die intermetallischen Schichten als strukturellen Teil der Lötstelle. Diskrete intermetallische Schichten sind in das Modell der Lötstelle eingefügt worden. Mit nichtlinearen FEM-Simulationen wurde dann untersucht, wie diese Schichten die gesamte nichtelastische Kriechdehnung in der Lötstelle beeinflussen und wie sich dies wiederum auf die Lebensdauer auswirkt.
Eine vernünftige Korrelation zeigte sich zwischen den experimentellen und den FEM-Ergebnissen: Eine um 20 bis 40 % höhere Lebensdauer ist bei Einsatz von Kobalt-UBM (statt Kupfer) zu erwarten. Damit wird deutlich, dass die UBM-Metallurgie einen großen Einfluss auf die Lötstellen-Lebensdauer hat. Eine mögliche Erklärung ist, dass die intermetallische Schicht mit ihrem niedrigeren Materialmodul als Übergangszone zwischen dem UBM und dem Lot fungiert. Dies reduziert die Starre der Lötstelle und somit auch die im Lot selbst auftretende Kriechdehnung (Bild 3).
Zusammenfassung
Wir haben unterschiedliche Aspekte der Zuverlässigkeit von bleifreien Lötstellen untersucht. Es gibt deutliche Fortschritte im Verständnis des thermo-mechanischen Verhaltens sowie der Elektromigration in einer Reihe von Bleifrei-Legierungen für Flip-Chip-Anwendung. In Fine-Pitch-Applikationen lässt sich Kobalt statt Kupfer in der UBM-Metallurgie einsetzen und damit können die Charakteristiken der Materialermüdung deutlich verbessert werden. All diese Ergebnisse sind besonders wichtig im Blick auf die Auswahl der am besten geeigneten Bleifrei-Legierung sowie des Oberflächenfinishes von Bauelemente-Anschlüssen.
EPP 474
Unsere Webinar-Empfehlung
Conformal Coating ist ein wichtiges Verfahren, um elektronische Baugruppen vor dem vorzeitigen Ausfall zu schützen. Damit bekommt der Beschichtungsprozess eine immer höhere Bedeutung. Dabei ist die Auftragsstärke ein wichtiges Qualitätskriterium. Nur eine zeitnahe schnelle Messung…
Teilen:




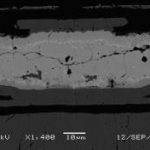
.png)







