Das Moldingsystem ASM-W von Fico (Besi-Unternehmensgruppe) ist eine Spritzpresse für Multi-Array- Packages (MAP), mit der sich die Fertigungskosten von einseitigen Gehäusen wie QFN, BGA, BOC und BGA-MAP sowie von anspruchsvolleren Konfigurationen wie Flip-Chips, Multichip-Arrays und gestapelten (stacked) Dies um bis zu 40 % gegenüber herkömmlichen Lösungen senken lassen. Diese Maschine enthält viele innovative Details, zum Teil patentiert, beispielsweise optimierte Abläufe, um Verbrauchsmaterial einzusparen, den Durchsatz zu vergrößern oder die Ausbeute zu steigern. Packagingprozess und der Verbrauch von Vergussmasse tragen erheblich zu den Bauteilkosten bei. Mit dem patentierten Fico-Verfahren Top-Edge-Gating zur Vereinzelung der Presslinge lassen sich bis zu 25 % des Epoxymaterials einsparen. Mit diesem Molding erfolgt die Zufuhr der Vergussmasse über die obere Klemmschiene, so dass die Verteilkanäle das Substrat nicht berühren. Die sonst nötige Goldschicht ist deswegen hier überflüssig – damit können rund 20 % der Kosten in Relation zum herkömmlichen Verfahren entfallen. Der schonende Transport auf Luftkissen in der Maschine erlaubt die Verarbeitung von sehr dünnen Substraten bis zu Papierdicke. Auch Substrate mit der Verdrahtung auf der Rückseite (BOC-Module) lassen sich damit komplikationslos handeln. Während des Transports wird der Halbleiter bereits erwärmt, dies reduziert die Aufheizzeit in der Presse und steigert den Durchsatz. Auch die dynamische Temperatursteuerung DTC erhöht den Durchsatz. Weil das Material im Spritzkanal langsamer aushärtet als das Formteil wird der Spritzkanal deutlich höher aufgeheizt, so dass das Material darin in der gleichen Zeit wie das Nutzteil aushärtet. Insbesondere dünne und großflächige Komponenten neigen beim Vergießen zu Welligkeiten. Durch kontrollierte Entwärmung unter Druck verlassen nur ebene Teile die Maschine, die sich optimal weiterverarbeiten lassen. Eine aktive Entlüftung sorgt außerdem dafür, dass Multichip-Module (MCM), gestapelte Dies und Flip-Chips mit Unterfüllung sicher mit großem Prozessfenster gleichmäßig verpackt werden, dazu erfolgt eine dynamische Drucksteuerung im Formnest in Abhängigkeit von der Transfer-Position über die Kavitäts-Vakuumkontrolle (CVC).
EPP 449
Unsere Webinar-Empfehlung
Conformal Coating ist ein wichtiges Verfahren, um elektronische Baugruppen vor dem vorzeitigen Ausfall zu schützen. Damit bekommt der Beschichtungsprozess eine immer höhere Bedeutung. Dabei ist die Auftragsstärke ein wichtiges Qualitätskriterium. Nur eine zeitnahe schnelle Messung…
Teilen:


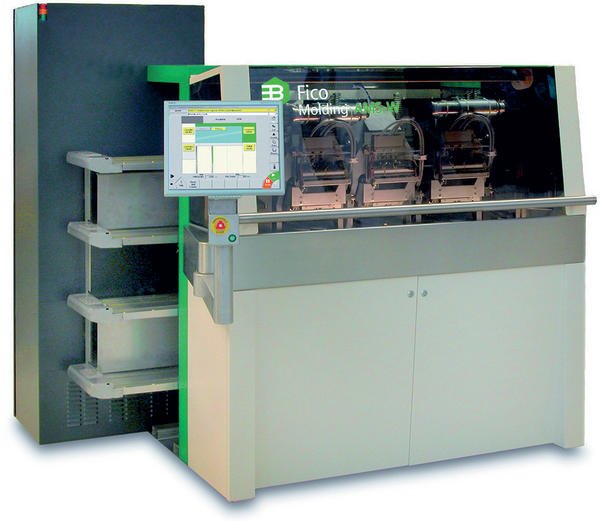
.png)







